
Nanofabrication laboratory equipment
 Nanolithography
Nanolithography
E-beam writer RAITH150 Two (RAITH)The Raith 150 Two is a high-resolution low voltage electron lithography (EBL) and metrology system. It is suitable for the research and development of MEMS, micro and nanoelectronic, plasmonic, photonic systems, and integrated optical devices. | |
 | Scanning Electron Microscope/E-beam writer TESCAN MIRA3/RAITH LIS (MIRA-EBL)A scanning electron microscope equipped with a laser interferometry stage capable of working with samples up to 50x50 mm2. Overlay and stitching accuracy below 100 nm, linewidth below 20 nm. |
 | UV Direct Write Laser system HEIDELBERG DWL 66-fs (DWL)The DWL 66FS laser lithography system is a high-resolution pattern generator for low-volume mask-making and direct writing. The capabilities and flexibility of this system allow the use of this research tool in MEMS, BioMEMS, Micro-Optics, ASICs, Micro Fluidics, Sensors, CGHs, and all other applications that require microstructures. |
 | ML3 Baby MicroWriter (ML3 BABY)The MicroWriter ML®3 Baby is a photolithography machine designed for rapid prototyping and small-volume manufacturing in R&D laboratories and clean rooms. |
 | Spin coater Laurell WS-650-23B (LAURELL)The Laurell WS-650-23 B spin coater is compact and packed with advanced features. This 650-series coater system will accommodate up to ø 150 mm wafers and 5" × 5" (127 mm × 127 mm) substrates and features a maximum rotational speed of 12,000 RPM (based on a ø 100 mm silicon wafer). |
 | Mask Aligner SÜSS MicroTec MA8 (SUSS-MA8)The Süss MicroTec MA8 is a standard UV lithography tool for exposing wafers through the mask. Exposure can be carried out in proximity mode or in contact mode. The MA8 is equipped with top-side optical microscopes and bottom-side microscopes, so alignment is possible from both sides of the wafer. |
 | Resist coating and development system SÜSS MicroTec RCD8 (SUSS-RCD8)The RCD8 coat and develop platform is equipped with a basic manual spin coater and a GYRSET® enhanced coater and puddle developer tool. It can handle small pieces as well as standard wafers up to 200 mm and therefore is ideal for daily R&D work up to small-scale production. |
 | Lithographic wetbench for coating (SUSS-WETBENCH)The wetbench provides a complete basic setup for substrate coating. It consists of the built-in spin-coater LabSpin 6 for manual resist dispense, two hot plate modules HP8, and one vapour primer VP8 for HMDS coating (adhesion promoter). |
 | Mechanical profilometer Bruker Dektak XT (DEKTAK)The Dektak stylus surface profiler is an advanced thin and thick film step height measurement tool. In addition to profiling surface topography and waviness, the Dektak system measures roughness in the nanometer range. |
 | Resist stripper Diener NANO Plasma cleaner (DIENER)The Diener NANO Plasma Cleaner with microwave generator can be used for resist stripping. Microwave plasma is ideal for most resist removal in modern device fabrication. |
 | Critical Point Dryer – Tousimis Autosamdri-815B (CPD)Critical point drying (CPD) is a well-established method for wafer and MEMS drying. It reduces the effects of deformation and shrinkage that occur when drying wet samples by conventional evaporation. |
 | Spectroscopic reflectometer Ocean Optics NanoCalc 2000 (NANOCALC)Multilayer characterization and resist thickness measurement mainly. The interval of measuring film thickness from 10 nm up to 100 µm. |
 | Optical microscope Zeiss Axio Imager A2 (ZEISS-NANO)Microscope Zeiss Axio Imager A2 is used to control lithography processes in reflected-light, bright field, and dark field. Equipped with a PC interface. |
 Etching & Deposition
Etching & Deposition
 | Deep reactive ion etching of Si-based materials, Oxford Instruments Plasma Technology PlasmaPro 100 (DRIE)Deep reactive-ion etching (DRIE) is a highly anisotropic etch process used to create deep penetration, steep-sided holes and trenches in wafers/substrates, typically with high aspect ratios. |
 | Experimental PECVD: ion and mass analyzer, optical emission spectroscopy (R4-EXPERIMENTAL-PECVD)The Experimental plasma-enhanced CVD reactor is constructed for the diagnostics of plasma chemical processes in capacitively coupled radio frequency (RF) discharges (13.56 MHz). It is possible to measure a delivered RF power, investigate the presence of plasma-excited species by optical emission spectroscopy, obtain information about the energy and flux of ions impinging on the substrate RF electrode, and measure mass and ion energy spectra of plasma phase particles. |
 | Large Plasma Enhanced CVD (R2-PECVD)The deposition chamber allows plasma processing of large substrates in capacitively coupled plasma (CCP). It is primarily used to deposit amine plasma polymers, i.e., organic thin films containing nitrogen functional groups, by plasma-enhanced chemical vapor deposition (PECVD). |
 | High-temperature plasma-enhanced chemical vapour deposition system on C-based materials, Oxford Instruments Plasma Technology NanoFab (PECVD-NANOFAB)Chemical vapour deposition system reaching very high deposition temperatures dedicated to the deposition of carbon nanomaterials, possibilities of plasma enhancement by discharges of different frequencies (including their regular switching). |
 | Ion beam etching Scia Systems Coat 200 (SCIA)The physical vapor deposition method allows thin films to be etched by the use of broad beams of positively charged ions in a high vacuum system. The system is equipped with a SIMS spectrometer for precise end-point detection. |
 | Magnetron sputtering system BESTEC (MAGNETRON)The system consists of a sputter deposition chamber with 8 magnetrons in a sputter-up configuration. The lid flange of the sputtering chamber is sealed with double viton O-rings and differentially pumped. |
 | Atmospheric Pressure chemical vapor deposition (APCVD)System for precisely controlled growth of oxides on silicon wafers in horizontal quartz tubes with the soft-loading placement of boats holding up to 50 wafers in one run. |
 | Low-Pressure chemical vapor deposition – amorphous Si (LPCVD-polySi)This position within the LPCVD system is dedicated to the growth of amorphous silicon on Si wafers, using silane (SiH4) as a precursor in the LPCVD process. |
 | Low-Pressure chemical vapor deposition – Si nitrides (LPCVD-SiN)This position within the LPCVD system is dedicated to the growth of silicon nitrides of different stechiometry on Si wafers, using dichlorosilane (SiCl2H2) and ammonia (NH3) as precursors in the LPCVD process. |
 | Plasma Enhanced CVD of Si-based materials, Oxford Instruments Plasma Technology PlasmaPro 100 (PECVD)Plasma-enhanced chemical vapor deposition is a method for the creation of thin films with thicknesses of a few tens of nanometers up to several micrometres. It belongs to CVD techniques that utilize reactants in the form of gases and vapors. |
 | RIE by Fluorine Chemistry and PECVD of hard C-based films, Oxford PlasmaPro NGP 80 (RIE-FLUORINE)Thin-film deposition by plasma-enhanced chemical vapour deposition. Etching of silicon and metals by reactive ion etching. |
 | RIE by Chlorine Chemistry, Oxford Instruments Plasma Technology PlasmaPro 100 (RIE-CHLORINE)Reactive-ion etching (RIE) is an etching technology used in microfabrication. RIE is a type of dry etching with different characteristics than wet etching. RIE uses chemically reactive plasma to remove material deposited on wafers. |
 | Electron beam evaporator BESTEC (EVAPORATOR)Thin-film deposition by electron beam evaporation. |
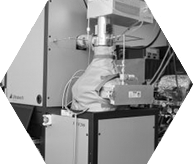 | Atomic layer deposition system, Ultratech/CambridgeNanoTech Fiji 200 (ALD)Atomic Layer Deposition is a deposition technique for very thin layers with the thickness control down to a single atomic layer. It belongs to the CVD techniques family. |
 | Ion-Beam Sputter Deposition System BESTEC (KAUFMAN)Suitable for Ion-beam sputter deposition, Ion-beam assisted deposition, reactive sputter deposition with nitrogen and in-situ initial/continual substrate (pre-)cleaning. |
 | SCS Parylene Deposition System (PARYLENE)For Parylene laboratory research, application development, and testing, the SCS Labcoater 2 Parylene Deposition System (PDS 2010) performs reliable and repeatable application of SCS Parylene conformal coatings. |
 | XeF2 etching system (XeF2)The XeF2 etching system is designed to expose samples to xenon difluoride gas (XeF2) in a cyclic mode in which the etch chamber is repeatedly filled with XeF2 gas and pumped out again. The main advantage of the XeF2 etching system in comparison to other silicon etchants is in high selectivity to silicon with respect to aluminium, photoresist, and silicon dioxide. Since this technique etches silicon isotropic, large structures can be undercut. |
 Packaging
Packaging
 | Laser dicer, Oxford Lasers A-Series (LASER-DICER)These laser micromachining systems are designed as versatile R&D, process development or pilot production systems. |
Wire bonder TPT HB 16 (WIREBONDER)Wire bonding is a micro-welding technique for electrical interconnection of the sample substrate structures and semiconductor chip thin metallic layers. Contact between the sample surface and pure gold, alloyed aluminium or copper wire is provided by three main methods: ultrasonic, thermocompression and thermosonic bonding. | |
 | Automatic dicing saw DAD 3221 (DISCO-DICING-SAW)A precision machine for cutting semiconductor wafers into individual chips or dice. |


 +420 54114 9207
+420 54114 9207  nano@ceitec.vutbr.cz
nano@ceitec.vutbr.cz


